
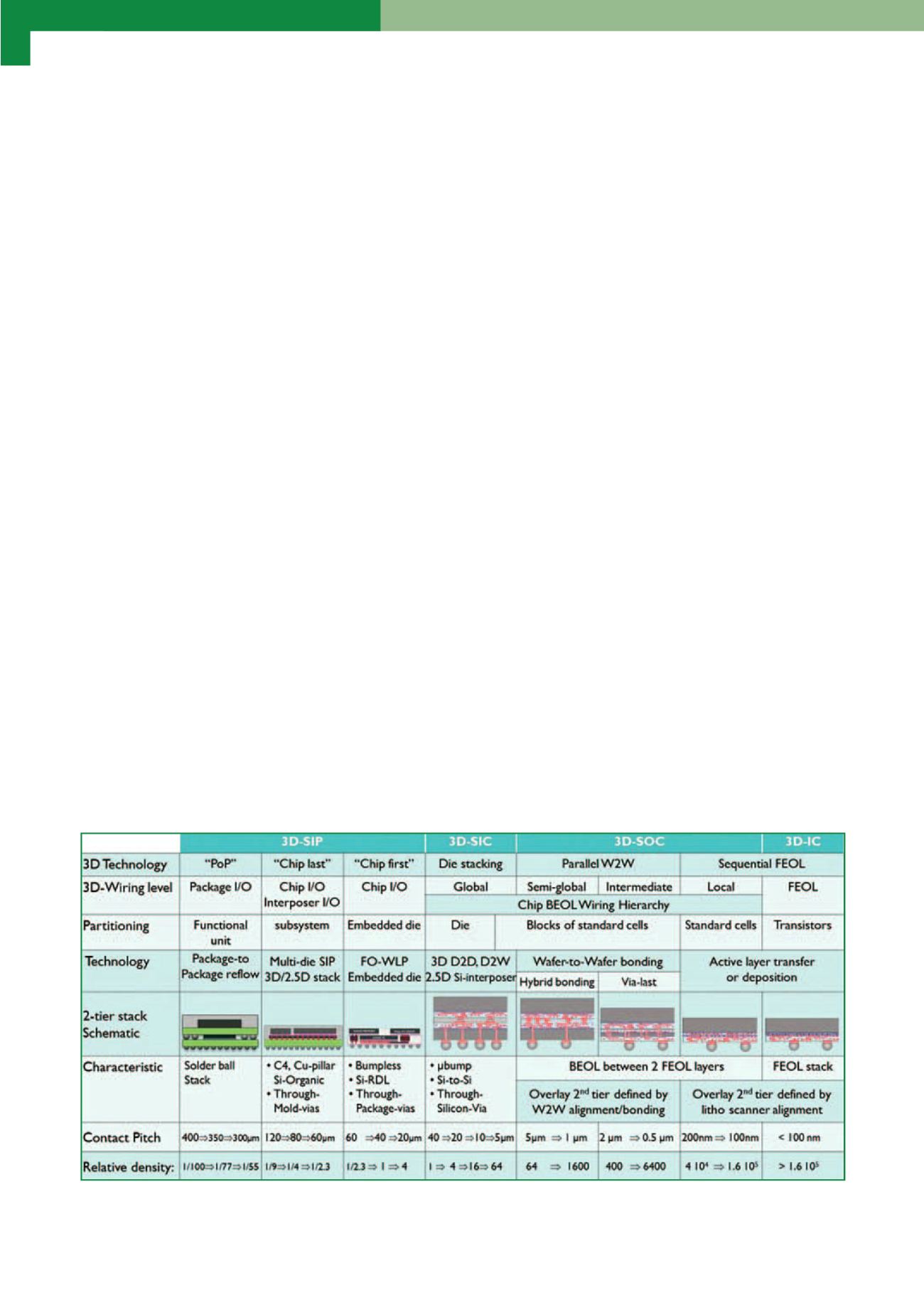
TECH INSIGHT
NEWS TECHNOLOGIES
22
- ELETTRONICA OGGI 469 - APRILE 2018
e sviluppo. La stampante 3D DragonFly 2020 Pro consente in pratica di produrre in casa prototipi di circuiti
stampati e di altri componenti elettronici. Dunque l’innovazione interessa soprattutto chi è impegnato nella fase
di sviluppo di nuovi prodotti e ha la necessità di testare le diverse soluzioni con prototipi fisici. La differenza
con la procedura normale, cioè affidare all’esterno la realizzazione di un prototipo, è enorme. Come ordine di
grandezza della tempistica, si passa da giorni a minuti.
www.cadlog.it/dragonflyI vantaggi della tecnologia 3D
Eric Beyne
Imec fellow e program director 3D system integration
I
l 2017 ha visto una svolta decisiva per la tecnologia 3D per i chip nei prodotti commerciali. Prima di allora
l’industria era sembrata piuttosto scettica rispetto a questa tecnologia, ma ora sta cominciando a rendersi
conto che il 3D non deve necessariamente costare di più. Crea, invece, nuove possibilità e opportunità
Il 3D sul mercato
Nel 2017 abbiamo visto iniziare a comparire la tecnologia 3D per i chip in una gamma di diversi prodotti com-
merciali. Per esempio, l’iPhone 8 utilizza il sensore di immagine “stacked” di Sony. Questo sensore offre una qua-
lità unica delle immagini sia per le foto che per i video perché il sensore di immagine, il chip di elaborazione e la
memoria sono stati raggruppati per creare una singola unità. Il 3D è anche la strada da percorrere per la memo-
ria. Si consideri, per esempio, l’uso crescente di moduli a elevata larghezza di banda. Questi moduli contengono
4 o 8 chip di memoria DRAM sovrapposti sul chip del processore. Nel 2017 sia AMD che Nvidia hanno portato
sul mercato potenti processori basati su questo principio. Questi processori possono essere utilizzati in laptop
di fascia alta, così come per applicazioni connesse all’intelligenza artificiale. Il 2017 ha inoltre fornito un note-
vole impulso alla tecnologia “fan-out wafer-level packaging” (WLP). Il fan-out WLP dovrebbe essere considerato
come il passaggio logico successivo al WLP standard, affrontando il problema del crescente disallineamento
e del gap di interconnessione tra chip e circuito stampato. I chip sono tagliati da un wafer di silicio e trasferiti
su un wafer di supporto, dove sono posizionati più distanti rispetto al wafer originale. Il wafer ricostruito viene
quindi rivestito con un composto epossidico, uno strato di ridistribuzione e sfere di saldatura. La tecnologia è
stata sviluppata circa 15 anni fa da Infineon, ma attualmente sta avendo un vero e proprio revival come modo
efficace per sovrapporre i wafer uno sopra l’altro. Il processore Apple A10, per esempio, utilizza la tecnologia
fan-out di TSMC, chiamata inFO, per sovrapporre la memoria DRAM alla CPU.
Lo scenario per la tecnologia 3D per i chip prospettato da imec


















