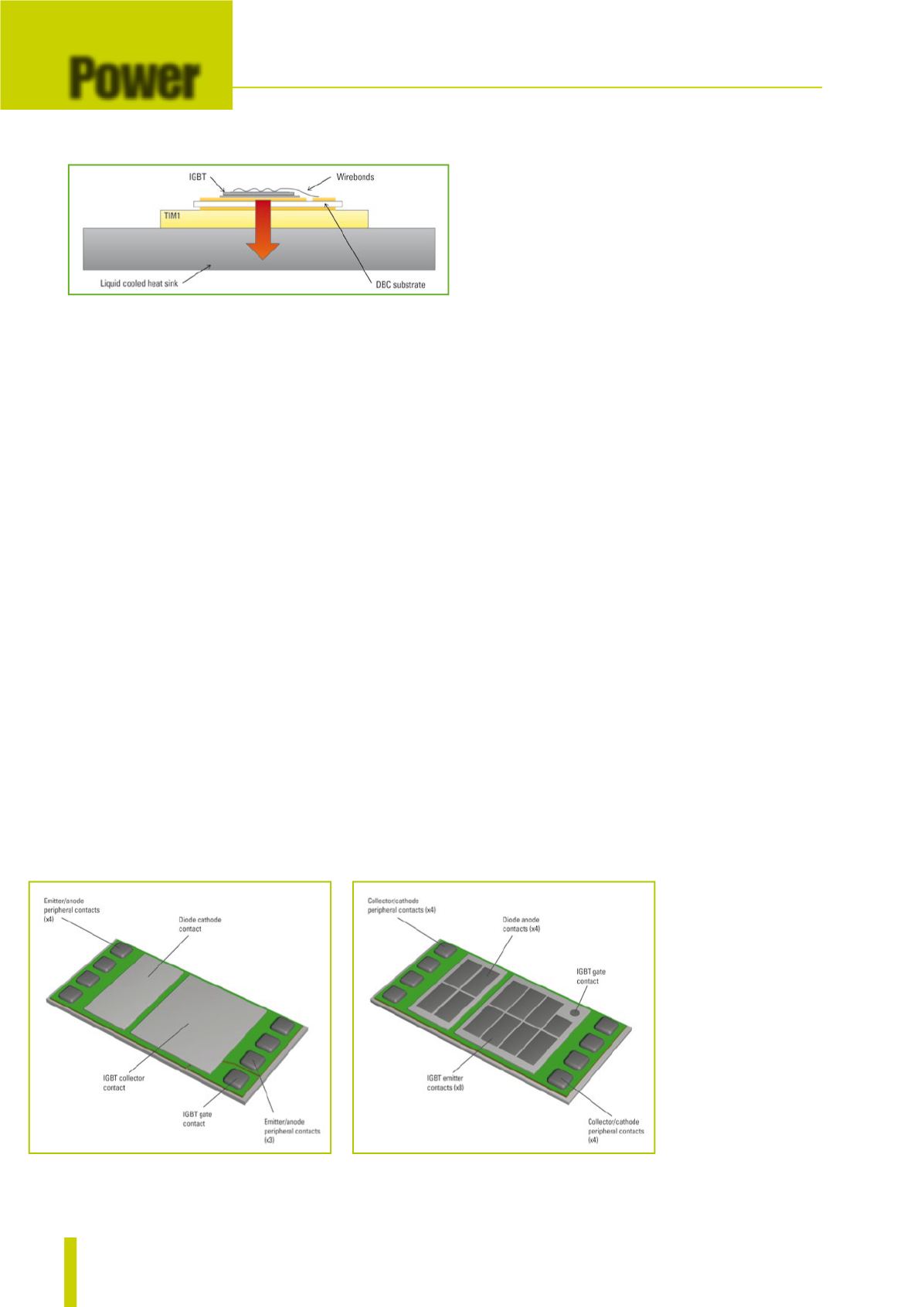
POWER 5 - luglio/agosto 2014
XII
Power
stenza termica tra il die e la base del modulo. Quest’ultima può
essere fittamente alettata per ottenere una migliore ventilazio-
ne o, più comunemente, raffreddata conunamistura liquida di
acqua e glicole. La figura 2 illustra la struttura termica e i con-
tatti elettrici di un tipico modulo di potenza IGBT moderno.
Per quanto riguarda gli IGBT, i dispositivi adatti alle moderne
applicazioni ad alta potenza devono poter gestire correnti fino
a 300A e oltre. Ciò si traduce in die di grandi dimensioni con
superfici di circa 100 mm
2
e più. Inoltre, i dispositivi di ultima
generazione sono fabbricati utilizzandouna tecnologia di wafer
ultrasottili con spessore del die pari a 100 µm o inferiore. Ciò
minimizza la lunghezza dei percorsi elettrici, migliorando ulte-
riormente le prestazioni nello stato di conduzione, e riduce la
carica dei portatori contribuendo ad aumentare l’efficienza di
commutazione. La tecnologia ultrasottile del die migliora an-
che la dissipazione del calore.
I die ultrasottili presentano tuttavia notevoli problemi in fase di
produzione che, in definitiva, possono trasformarsi in una resa
finalepiùbassa. Imoduli vengono tipicamente assemblati utiliz-
zando un IGBT a chip nudo, annullando qualsiasi resistenza di
incapsulamento die-free (Die-Free Package Resistance, DFPR)
o resistenza termica del package (Package Thermal Resistance,
R
THj-c
) relativa a un contenitore secondario, aumentando quin-
di l’efficienza energetica e le prestazioni termiche. Die ampi
e ultrasottili possono rompersi nel momento in cui vengono
estratti dai relativi supporti o nelle successive lavorazioni. Si po-
trebbero utilizzare speciali attrezzature per maneggiare questi
componenti, ma ci sono altri effetti relativi ai die di grandi di-
mensioni che possono direttamente influenzare l’affidabilità
quando i moduli sono esposti a cicli termici. Un die di gran-
di dimensioni genera elevati disadattamenti nei coefficienti di
espansione termica (CTE) tra il die e il substrato del modulo,
esercitando notevoli sollecitazioni sui giunti di saldatura del die
o sul die vero e proprio. Dopo diversi cicli termici, i giunti di sal-
datura del die tendono a degradarsi provocando un aumento
della resistenza termica tra il die dell’IGBT e il substrato. Ciò
può surriscaldare il modulo, riducendone le prestazioni e, in
definitiva, anticipandone la rottura.
Gli effetti dei disadattamenti dei coefficienti di espansione ter-
mica tra i materiali presenti nella struttura possono essere ridot-
ti saldando il die su un substrato DBC (Direct-Bond Copper).
In questo tipo di architettura, le interconnessioni (wirebond)
di alluminio illustrate in figura 2 vengono utilizzate per colle-
gare l’emettitore dell’IGBT ai contatti del modulo. Di solito
vengono utilizzati diversi conduttori di sezione elevata con dia-
metri tipicamente nella fascia da 0,25 mm (0,01 pollici) a 0,5
mm (0,02 pollici). I test di affidabilità hanno mostrato che l’in-
terfaccia tra le interconnessioni e la metallizzazione superiore
è vulnerabile alla fatica e pertanto pone un limite alla vita del
modulo. I costruttori di moduli devono vincere un altro ostaco-
lo alla produttività che si verifica durante il collaudo finale. Ti-
picamente, i die utilizzati nei chip di potenza a semiconduttore
non possono essere collaudati alla massima corrente operativa
prima di essere incapsulati. Pertanto, alcuni tipi di guasti relativi
al chip nudo potrebbero manifestarsi solo nel collaudo finale
del modulo assemblato. Ciò può ridurre il numero effettivo di
assemblati prodotti.
Prestazioni di un chip nudo... in un contenitore
COOLiR
2
Die di IR è una nuova tecnologia di packaging con-
cepita per superare gli inconvenienti del tradizionale sistema
bare-die. Il die è attaccato direttamente su un substrato DBC, il
cui coefficiente di espansione termica è simile a quello del sili-
cio. Questo substrato fornisce un supportomeccanico al die ed
elimina la necessità delle inter-
connessioni, permettendo un
raffreddamento su entrambi i
lati al fine di migliorare le pre-
stazioni termiche. I dispositivi
possono essere forniti in confe-
zioni “tape and reel” e posizio-
nati sfruttando le tradizionali
apparecchiature per montag-
gio superficiale (SMT). Gli elet-
trodi del die sono rifiniti con
una metallizzazione in argento
che li rende saldabili. Questa
è una differenza importante
quando si fa il confronto con
i die utilizzati nei tradizionali
Fig. 2 – Dettagli costruttivi di un tipico modulo di po-
tenza IGBT
Fig. 4 – Configurazione die-up
(die diritto)
Fig. 3 – Configurazione flipped-die
(die rovesciato)